
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe i Déantúsaíocht Sliseanna: Tuairisc Nuachta Gairmiúla
Éabhlóid Ábhair Leathsheoltóra
I réimse na teicneolaíochta leathsheoltóra nua-aimseartha, tá an tiomáint gan staonadh i dtreo miniaturization tar éis teorainneacha na n-ábhar traidisiúnta sileacain-bhunaithe a bhrú. Chun freastal ar na héilimh ar ardfheidhmíocht agus tomhaltas ísealchumhachta, tá SiGe (Silicon Germanium) tagtha chun cinn mar ábhar ilchodach de rogha i ndéantúsaíocht sliseanna leathsheoltóra mar gheall ar a airíonna fisiceacha agus leictreacha uathúla. Pléann an t-alt seo isteach sapróiseas epitaxyde SiGe agus a ról i bhfás epitaxial, feidhmchláir sileacain faoi bhrú, agus struchtúir Gate-All-Around (GAA).
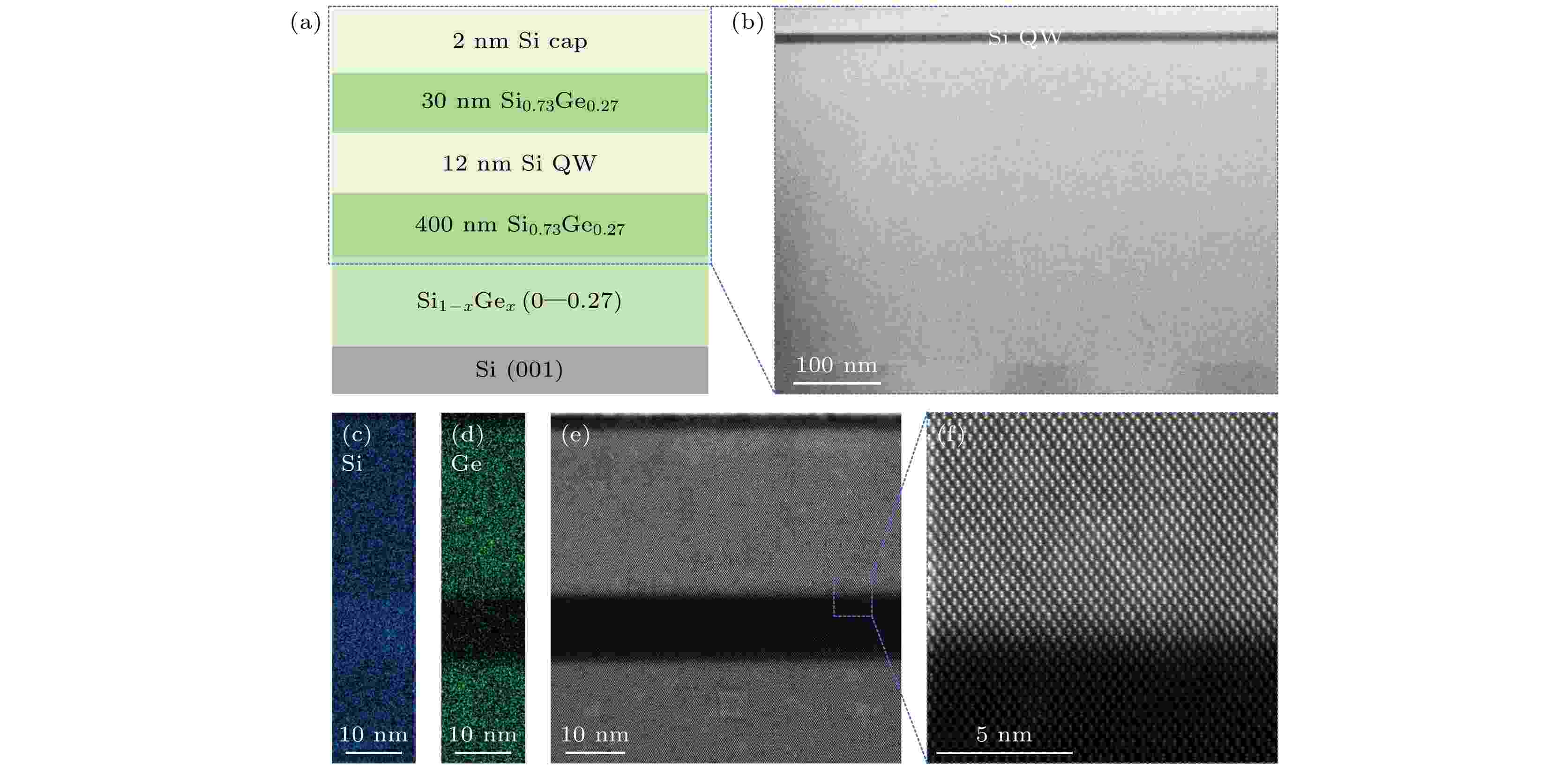
Tábhacht SiGe Epitaxy
1.1 Réamhrá ar Epitaxy i Déantúsaíocht Sliseanna:
Tagraíonn Epitaxy, a ghiorrú go minic mar Epi, d'fhás ciseal aonchriostail ar fhoshraith aonchriostail leis an socrú laitíse céanna. Is féidir an ciseal seo a bheith ceachtarhomoepitaxial (amhail Si/Si)nó heteroepitaxial (cosúil le SiGe/Si nó SiC/Si). Baintear úsáid as modhanna éagsúla le haghaidh fáis epitaxial, lena n-áirítear Eipiteacs Líoma Mhóilíneach (MBE), Siosta Gail Cheimiceach Ultra-Ard-Fholúis (UHV/CVD), Eipiteaxy Atmaisféir agus Brú Laghdaithe (ATM & RP Epi). Díríonn an t-alt seo ar phróisis epitaxy sileacain (Si) agus sileacain-germanium (SiGe) a úsáidtear go forleathan i dtáirgeadh ciorcad comhtháite leathsheoltóra le sileacain mar ábhar an tsubstráit.
1.2 Buntáistí SiGe Epitaxy:
Ionchorprú cuid áirithe de gearmáiniam (Ge) le linn anpróiseas epitaxycruthaíonn sé ciseal aonchriostail SiGe a laghdaíonn ní amháin leithead an bhanda ach a mhéadaíonn minicíocht scoite (fT) an trasraitheora freisin. Mar sin tá sé infheidhme go forleathan i bhfeistí ard-minicíochta le haghaidh cumarsáide gan sreang agus optúil. Thairis sin, i bpróisis chiorcaid chomhtháite chun cinn CMOS, cuireann an neamhréir laitíse (thart ar 4%) idir Ge agus Si isteach strus laitíse, ag cur le soghluaisteacht leictreon nó poill agus mar sin méadú ar sháithiú reatha an fheiste agus ar luas freagartha.
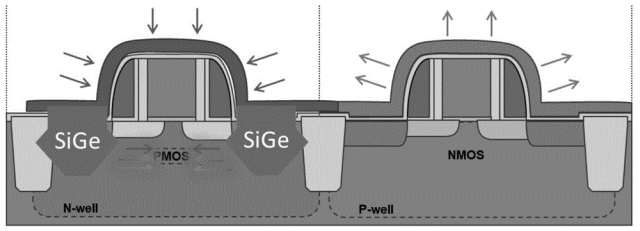
Sreabhadh Próiseas Cuimsitheach SiGe Epitaxy
2.1 Réamhchóireáil:
Déantar réamhchóireáil ar sliseoga sileacain bunaithe ar thorthaí an phróisis atá ag teastáil, go príomha baintear an ciseal ocsaíd nádúrtha agus neamhíonachtaí ar dhromchla na sliseog. I gcás sliseog tsubstráit tromdhópáilte, tá sé ríthábhachtach a mheas an bhfuil gá le cúlshéalaithe chun uathdhópáil a laghdú le linn na tréimhse ina dhiaidh sin.fás epitaxy.
2.2 Gáis agus Coinníollacha Fáis:
Gáis sileacain: Is iad Silane (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), agus Trichlorosilane (TCS, SiHCl₃) na trí fhoinse gáis sileacain is coitianta a úsáidtear. Tá SiH₄ oiriúnach do phróisis epitaxy iomlána íseal-teocht, agus úsáidtear TCS, ar a dtugtar as a ráta fáis tapa, go forleathan le haghaidh ullmhú tiubhepitaxy sileacainsraitheanna.
Gás Gearmáiniam: Is é Germane (GeH₄) an phríomhfhoinse chun gearmáiniam a chur leis, a úsáidtear i gcomhar le foinsí sileacain chun cóimhiotail SiGe a fhoirmiú.
Epitaxy Roghnach: Baintear fás roghnach amach trí rátaí coibhneasta nasil-leagan epitaxialagus eitseáil in situ, ag baint úsáide as DCS gás sileacain ina bhfuil clóirín. Tá an roghnaíocht mar gheall ar asaithe na n-adamh Cl ar an dromchla sileacain a bheith níos lú ná sin ar ocsaídí nó nítrídí, rud a éascaíonn fás epitaxial. Go ginearálta ní chuirtear SiH₄, gan adaimh Cl in ann agus le fuinneamh gníomhachtaithe íseal, i bhfeidhm ach ar phróisis epitaxy iomlána íseal-teocht. Tá brú íseal gaile ag foinse sileacain eile a úsáidtear go coitianta, TCS, agus tá sé leacht ag teocht an tseomra, rud a éilíonn H₂ bubbling chun é a thabhairt isteach sa seomra imoibrithe. Mar sin féin, tá sé réasúnta saor agus is minic a úsáidtear é le haghaidh a ráta fáis tapa (suas le 5 μm/nóim) chun sraitheanna epitaxy sileacain níos tiús a fhás, a chuirtear i bhfeidhm go forleathan i dtáirgeadh wafer epitaxy sileacain.
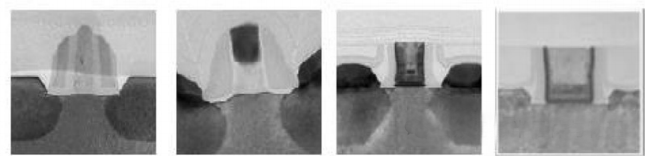
Sileacan Strained i Sraitheanna Eipiteascópacha
I rithfás epitaxial, taisceadh epitaxial aon-criostail Si ar chiseal SiGe suaimhneach. Mar gheall ar an neamhréir laitíse idir Si agus SiGe, tá an ciseal aonchriostail Si faoi réir strus teanntachta ón gciseal SiGe bhunúsach, rud a chuireann go mór le soghluaisteacht leictreon i dtrasraitheoirí NMOS. Ní hamháin go méadaíonn an teicneolaíocht seo sruth sáithiúcháin (Idsat) ach feabhsaíonn sé luas freagartha gléas freisin. Maidir le feistí PMOS, déantar sraitheanna SiGe a fhás go epitaxially sna réigiúin foinse agus draein tar éis eitseáil chun strus comhbhrúiteach a thabhairt isteach ar an gcainéal, feabhas a chur ar shoghluaisteacht poll agus méadú ar sháithiú reatha.
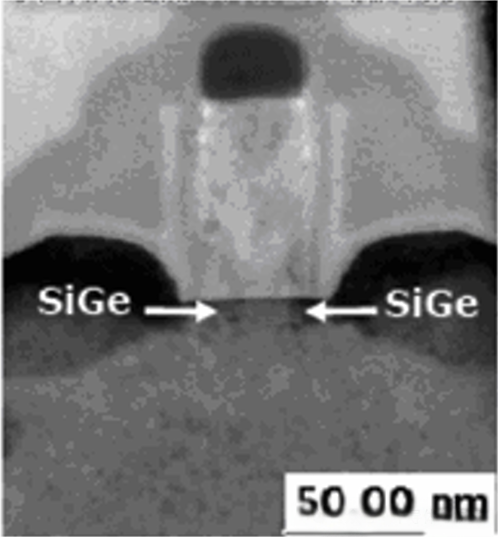
SiGe mar Chiseal Íobairt i Struchtúir CLG
Agus trasraitheoirí nanowire Gate-Around (GAA) á ndéanamh, feidhmíonn sraitheanna SiGe mar shraitheanna íobartacha. Ligeann teicnící eitseála anisotrópacha ard-roghnacha, mar eitseáil chiseal gar-adamhach (quasi-ALE), do bhaint beacht sraitheanna SiGe chun struchtúir nana-bhileog nó nana-bhileoga a fhoirmiú.
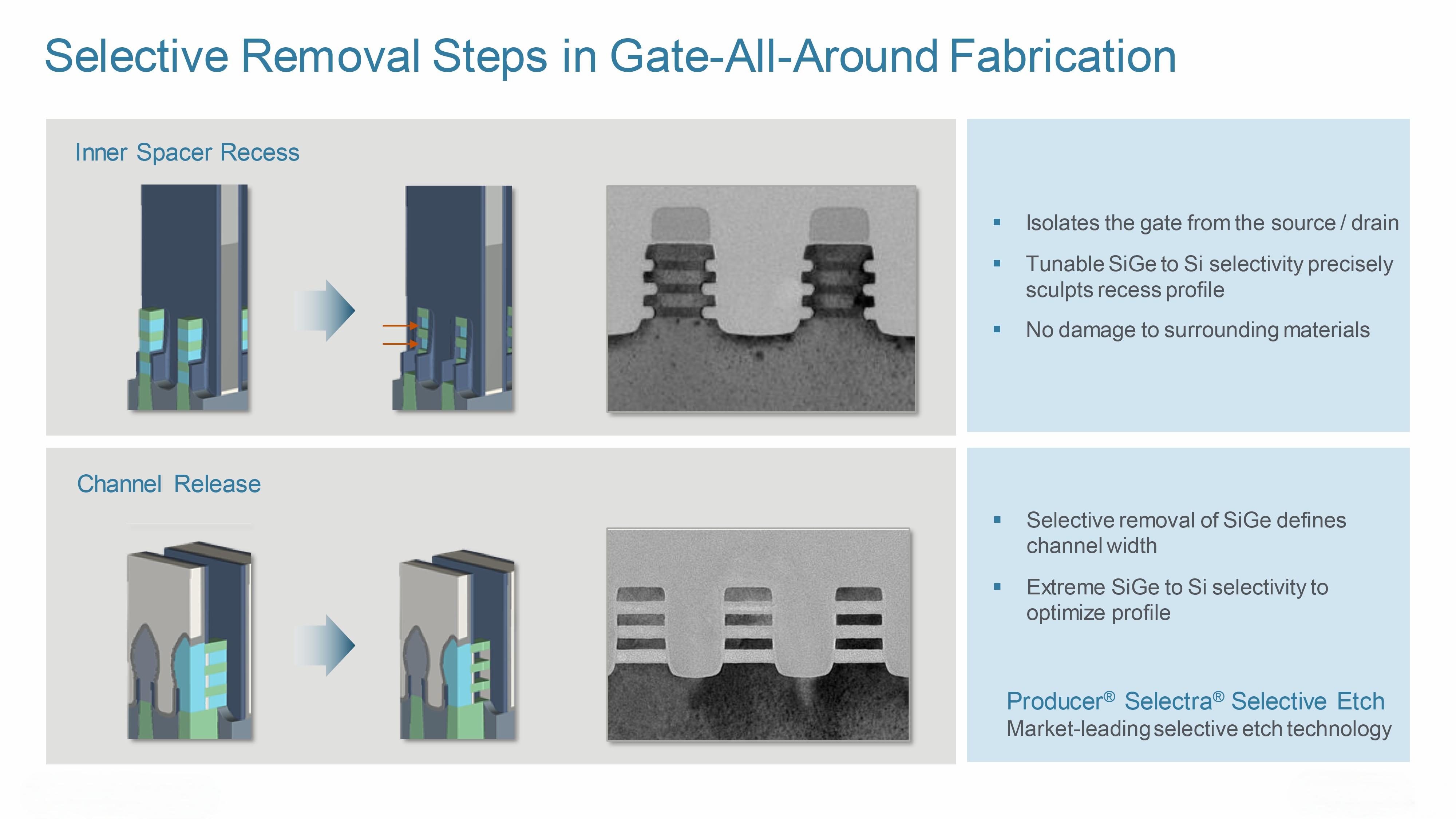
Táimid ag Semicorex speisialtóireacht iRéitigh graifíte brataithe SiC/TaCcurtha i bhfeidhm i bhfás epitaxial Si i ndéantúsaíocht leathsheoltóra, má tá aon fhiosrúcháin agat nó má tá sonraí breise uait, ná bíodh aon leisce ort teagmháil a dhéanamh linn.
Fón teagmhála: +86-13567891907
Ríomhphost: sales@semicorex.com




